臭氧源的前瞻性需求:面向GAA晶体管、3D NAND等先进制程的挑战
在3nm及以下逻辑芯片、200层以上3D NAND存储芯片的先进制程中,臭氧凭借其强氧化性、低温工艺适配性、原子级反应可控性,成为原子层刻蚀(ALE)、原子层沉积(ALD)、高深宽比结构处理、晶圆无损伤清洗、高k介质界面工程等核心工艺的关键介质。而GAA(环绕栅极)晶体管、超高堆叠3D NAND的结构革新与制程极限,对臭氧源的纯度、稳定性、可控性、输运能力提出了远超成熟制程的前瞻性要求,同时也带来了一系列技术挑战。
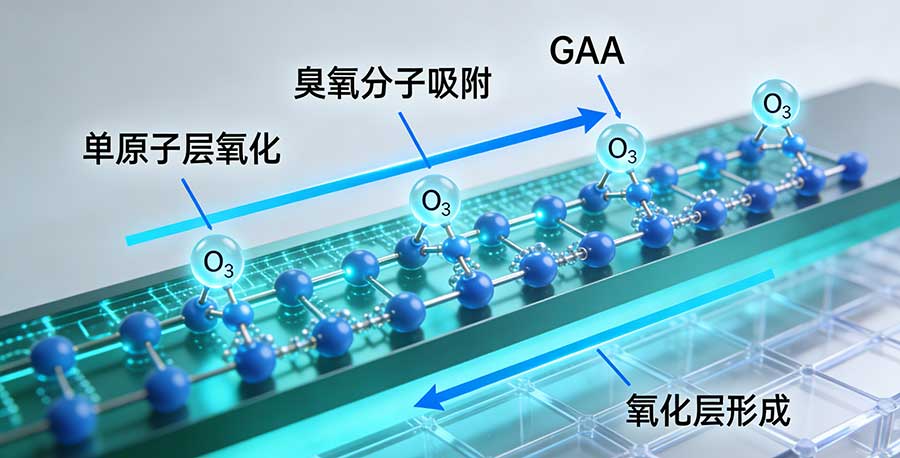
一、GAA晶体管(含后续CFET)先进制程的核心需求与挑战
GAA是3nm节点的量产核心架构,2nm及以下节点将向纳米线、多桥通道结构演进,更远期的CFET(互补场效应晶体管)将实现垂直堆叠的n/p型器件集成,其核心特征是沟道尺寸缩至纳米级、3D环绕栅极结构、热预算极低、工艺损伤容忍度趋近于零,对臭氧源的需求聚焦于原子级精度、超高选择性、无损伤工艺适配三大核心方向。
(一)核心应用场景与前瞻性需求
1. 纳米片/纳米线沟道的原子级选择性氧化与刻蚀
GAA沟道释放工艺需要对Si/SiGe异质结进行单原子层精度的选择性刻蚀/氧化,要求臭氧仅靶向氧化特定材料,不损伤超薄沟道晶格。前瞻性需求为:实现不同半导体材料间的氧化选择比>1000:1,单循环氧化厚度控制精度<0.1nm,无等离子体电荷损伤,适配脉冲式ALE工艺的纳秒级剂量通断控制。
2. 高k栅介质界面层(IL)的低温保形制备
GAA环绕栅极的界面层厚度<1nm,其均匀性直接决定器件漏电、载流子迁移率与可靠性,传统高温热氧化会引发纳米结构形变与材料扩散,低温臭氧氧化是唯一可行方案。前瞻性需求为:室温~400℃低温下,在高深宽比(>10:1)的纳米片间隙中,实现3D环绕结构的氧化厚度片内偏差<0.05nm,氧化膜致密无针孔、界面态密度<10¹⁰ cm⁻²·eV⁻¹。
3. 纳米级间隙的无损伤超洁净清洗
GAA纳米片间隙仅2~3nm,传统湿法清洗易产生毛细效应与结构坍塌,臭氧基干法/超临界清洗可实现有机残留、金属杂质、纳米颗粒的无损伤去除。前瞻性需求为:臭氧金属杂质、卤素杂质、含氮杂质控制至ppt级,可去除粒径<7nm的颗粒污染物,清洗后无残留、无晶格损伤,适配12英寸晶圆的片间均匀性<±0.3%。
(二)核心技术挑战
1. 纯度与杂质控制挑战
成熟制程臭氧源纯度要求为99.9%、金属杂质ppb级,而GAA先进制程要求臭氧纯度>99.9999%,全杂质总量控制至ppt级。核心难点在于:臭氧通过氧气放电产生,放电过程易生成NOx、CO等副产物,电极与管路材料易析出金属离子;同时高浓度臭氧具有强腐蚀性,常规纯化材料易被氧化失效,难以实现长期稳定的ppt级杂质控制,且需满足半导体制程>10万小时的平均无故障时间(MTBF)要求。
2. 臭氧稳定性与剂量精准控制挑战
臭氧本身具有热不稳定性,在低压、高温工况下易分解,从发生器到工艺腔体的输运过程中,浓度衰减与活性损失会直接导致工艺偏差。核心难点在于:实现臭氧浓度长期波动<±0.2%,亚sccm级流量精准控制,同时在真空腔体中保持臭氧分子与活性自由基的稳态,匹配ALE工艺的脉冲式注入需求,避免剂量累积误差导致的器件线宽偏差与良率损失。
3. 高深宽比3D结构的保形输运挑战
GAA纳米片、CFET垂直堆叠结构的高深宽比将突破20:1,纳米级间隙会限制臭氧分子的扩散效率,易出现“顶部过氧化、底部氧化不足”的保形性失效。核心难点在于:突破常规气相扩散的极限,通过臭氧发生模式与输运方案的革新,让臭氧分子/活性自由基均匀到达3D结构的底部、侧壁与上下表面,实现全结构的反应均匀性偏差<1%。
二、超高堆叠3D NAND先进制程的核心需求与挑战
3D NAND已进入200层以上量产阶段,远期将向500层、1000层堆叠演进,其核心特征是通道孔/沟槽的高深宽比持续突破、多层薄膜堆叠的应力控制严苛、大规模量产对设备稳定性与成本敏感度很高,对臭氧源的需求聚焦于极限高深宽比保形能力、大流量高稳定性、量产级长周期可靠性三大核心方向。
(一)核心应用场景与前瞻性需求
1. 极限高深宽比通道孔的侧壁保形氧化与钝化
1000层3D NAND的通道孔高深宽比将突破100:1,孔径<20nm、深度达数十微米,传统热氧化无法实现孔口到孔底的均匀氧化,臭氧低温氧化是核心解决方案。前瞻性需求为:在HAR>100:1的通道孔中,实现从孔口到孔底的氧化厚度偏差<2%,氧化膜致密性满足漏电抑制要求,适配12英寸晶圆的批次一致性偏差<±0.5%。
2. 字线替换工艺的高选择性刻蚀与残留清洗
3D NAND的SiO₂/Si₃N₄交替堆叠结构,在字线替换工艺中需要对牺牲层进行高选择比刻蚀,同时去除刻蚀副产物与有机残留。前瞻性需求为:臭氧辅助刻蚀实现Si₃N₄与SiO₂的选择比>50:1,对W、TiN等金属栅极材料无腐蚀,无结构坍塌与层间剥离风险,适配多层堆叠的超薄层(<5nm)工艺控制。
3. 晶圆级薄膜沉积与缺陷修复
臭氧基ALD工艺是3D NAND ONO堆叠层、多晶硅通道薄膜制备的核心方案,同时可实现堆叠层针孔缺陷的原位修复。前瞻性需求为:大流量(数十slm)工况下保持臭氧浓度>200g/Nm³,长期运行浓度波动<±0.5%,适配连续式量产工艺的不间断运行需求,降低单晶圆工艺成本。
(二)核心技术挑战
1. 极限高深宽比结构的输运与反应均匀性挑战
100:1以上的通道孔中,臭氧分子的平均自由程受限,常规输送方式下孔底臭氧浓度仅为孔口的10%以内,直接导致氧化/刻蚀均匀性失效。核心难点在于:突破气相扩散极限,通过脉冲式注入、等离子体活化自由基束流、压力脉动调控等方案,提升臭氧在纳米级深孔中的填充能力与扩散效率,实现全孔道的均匀反应。
2. 大流量高浓度与量产级长期稳定性挑战
3D NAND大规模量产要求臭氧源24小时不间断运行,MTBF>15万小时,同时需要大流量、高浓度的稳态输出。核心难点在于:在大流量(>50slm)工况下,保持高浓度臭氧的稳定生成,避免放电不均、电极老化导致的浓度漂移;同时提升放电效率,降低能耗与耗材更换成本,适配存储芯片量产的成本控制要求。
3. 多层堆叠结构的低温工艺与应力控制挑战
200层以上的堆叠结构对热预算极为敏感,高温工艺会引发层间应力累积、薄膜开裂、材料互扩散,要求工艺温度全程控制在400℃以内。核心难点在于:在低温环境下提升臭氧的氧化活性与反应速率,同时保证氧化膜的致密性与可靠性,避免低温氧化导致的膜层缺陷与器件漏电失效。

三、臭氧源面向先进制程的前瞻性技术突破方向
针对GAA、3D NAND先进制程的核心需求与挑战,臭氧源技术将向一体化、高精度、智能化、高适配性方向演进,核心突破方向如下:
1. 超高纯度臭氧发生与原位纯化一体化技术
集成无电极微波放电/优化型介质阻挡放电(DBD)单元与原位纯化模块,减少电极材料的杂质析出,通过低温吸附、催化分解原位去除NOx、CO、金属杂质等副产物,实现出口臭氧纯度>99.9999%,杂质控制至ppt级,同时延长纯化模块寿命,满足量产级长期运行需求。
2. 脉冲式活性臭氧自由基可控发生技术
开发纳秒级脉冲式臭氧发生系统,精准控制臭氧注入剂量与通断时序,结合低损伤等离子体辅助技术,调控活性氧自由基(O¹D、O³P)的比例与能态,既满足ALE/ALD工艺的单原子层控制精度,又提升臭氧在高深宽比结构中的扩散能力与保形性。
3. 大流量模块化高稳定臭氧发生技术
针对3D NAND量产需求,开发标准化并联模块化DBD臭氧发生器,实现单台设备>100slm的大流量、>300g/Nm³的高浓度臭氧输出;搭载智能闭环控制系统,实时监测浓度、流量、温度参数并动态调整放电工况,保证浓度波动<±0.2%,同时提升放电效率,降低运行能耗与成本。
4. 全路径臭氧输运与工艺协同控制技术
构建从发生器到工艺腔体的全路径温度、压力、材质协同控制系统,采用惰性钝化管路与精准温控方案,将输运过程中的臭氧浓度损失控制在5%以内;结合工艺腔体的压力脉动、晶圆载台温控设计,优化臭氧在高深宽比结构中的填充与反应过程,实现晶圆级工艺均匀性的极致控制。
5. 工艺适配型智能臭氧源系统
突破传统“单一发生器”的产品形态,打造集成多参数在线监测、工艺联动控制、故障预警与寿命预测的智能系统,可与刻蚀机、ALD设备、清洗机的工艺参数实时联动,自动适配GAA沟道释放、3D NAND通道孔氧化等不同工艺场景的参数需求,提升设备稼动率与晶圆良率。
四、产业现状与展望
当前,面向半导体先进制程的臭氧源核心市场被日本住友精密、富士电机,美国MKS、Astex等企业垄断,国内厂商已在成熟制程实现国产化突破,但在2nm以下GAA、200层以上3D NAND对应的高端臭氧源领域,仍存在纯度控制、长期稳定性、工艺适配性等核心差距。北京为半导体行业提供高浓度臭氧源解决方案。
随着全球半导体制程持续向物理极限推进,臭氧源已从辅助配套设备升级为决定先进制程工艺能力的关键核心部件。未来,需要实现材料、放电技术、纯化技术、精密控制与半导体制程工艺的协同创新,完成前瞻性技术布局与国产化突破,支撑GAA、超高堆叠3D NAND等先进制程的自主可控发展。



 当前位置:
当前位置: 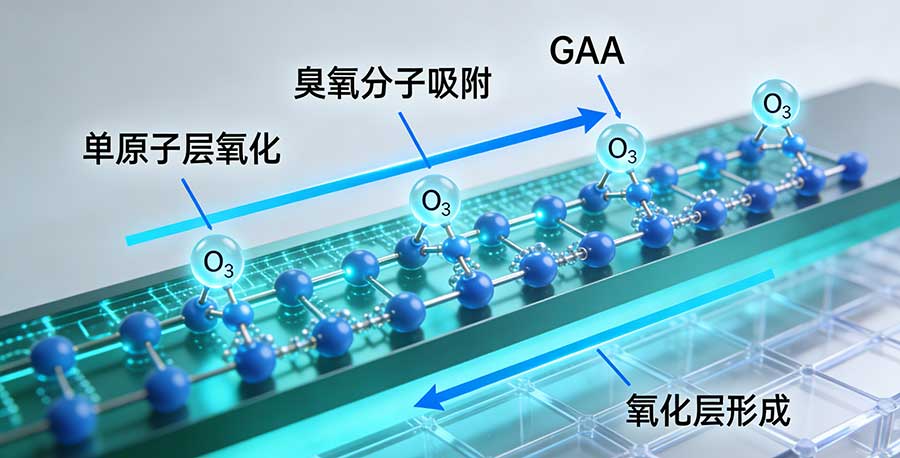
 摘要
摘要
 上一篇:
上一篇: 返回列表
返回列表
